050621_04
僨僕僇儊岦偗0.5儈儕偺嫹僺僢僠偱暋悢偺僷僢働乕僕傪愊憌偟幚憰柺愊傪42%嶍尭偟偨俁師尦僔僗僥儉丒僀儞丒僷僢働乕僕 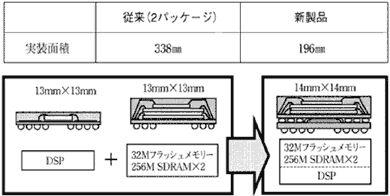 僔儍乕僾偼嬈奅偱弶傔偰暋悢偺僷僢働乕僕傪愙懕抂巕0.5儈儕偺嫹僺僢僠偱愊憌偟偨俁師尦僔僗僥儉丒僀儞丒僷僢働乕僕乽3D-SiP乿傪奐敪偟偨丅 俢俽俹傪搵嵹偟偨壓僷僢働乕僕乮係俀係僺儞乯偲俁俀俵俶俷俼宆僼儔僢僔儏儊儌儕乕偲丄俆侾俀俵價僢僩俽俢俼俙俵乮俀俆俇俵俽俢俼俙俵亊俀乯傪搵嵹偟偨忋僷僢働乕僕乮侾俇俀僺儞乯偲傪愊憌偟偰侾僷僢働乕僕壔偟偨丅 壓丄忋椉僷僢働乕僕偺愙懕抂巕偺儃乕儖僺僢僠傪嬈奅嵟嫹偺侽丒俆儈儕偵偡傞偙偲偵傛傝丄廬棃偺俢俽俹偲俁俀俵俶俷俼宆僼儔僢僔儏儊儌儕乕丒俀俆俇俵俽俢俼俙俵偺俀僷僢働乕僕峔惉昳偵斾傋幚憰柺愊傪係俀亾嶍尭偱偒傞丅 傑偢丄俢俽俠梡僔僗僥儉俴俽俬偲偟偰忋僷僢働乕僕偵俁俀俵僼儔僢僔儏儊儌儕乕侾僠僢僾丄俀俆俇俵俽俢俼俙俵俀僠僢僾搵嵹偺乽俴俼俁俉俇俉俁乿偲摨奺侾僠僢僾搵嵹偺乽俴俼俁俉俇俉俀乿傪崱寧枛偵僒儞僾儖弌壸偟丄俈寧偐傜検嶻傪奐巒偡傞丅 偲傕偵僷僢働乕僕僒僀僘14亊14亊1.7儈儕丅係俀係僺儞丅俉丄俋寧敪攧儌僨儖偵搵嵹偝傟傞丅侽俇擭偵偼実懷揹榖側偳偺儌僶僀儖婡婍偵傕嫙媼偡傞寁夋丅 儃乕儖僺僢僠傪廬棃偺0.65儈儕偐傜0.5儈儕偵偡傞偙偲偱壓丄忋僷僢働乕僕偺俛俧俙儃乕儖傪僷僢働乕僕偺抂偵婑偣傞偙偲偑偱偒偨丅壓僷僢働乕僕偺僷僢働乕僕崅偝傪儃乕儖崅偝0.28儈儕+婎斅崅偝0.2儈儕+儌乕儖僪崅偝0.19儈儕偺僩乕僞儖0.7儈儕俿倄俹偵梷偊偨丅 |
||||||||||||