060303_02
30マイクロピッチ接続のチップオンチップ技術とCOC-FCBGAパッケージ 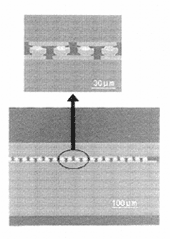 ルネサス テクノロジは2日、デジタル機器、高速ネットワーク機器などの高性能化を実現する次世代のパッケージング技術として、30マイクロメートルの微細ピッチ接続によるチップ・オン・チップ(COC)技術と、この技術を使用したCOC-FCBGA(フリップチップ・ボール・グリッドアレイ)パッケージを開発したと発表した。同社では、06年第4四半期を目標に、この技術の実用化を目指す。 COCは、複数のチップを積層した構造で、今回の技術は2枚のチップについて、それぞれの表面(回路形成面)の電極同士を微小バンプと微細ピッチで直接接続するもの。これにより、チップ間のデータ転送速度の大幅な高速化と超多ピン接続を可能にする。 新技術は、フラックスを用いず、加熱溶融により低ダメージのフリップチップ接続を行うもので、30マイクロメートルの微細ピッチで鉛フリーハンダの微小バンプを形成し、低荷重で加圧し、加熱により接続する。これにより、1チップ当たり1万バンプを超える超多ピン接続をフラックスを用いずにフリップチップ接続が可能なことを確認している。 また、鉛フリーハンダの形成は、マイクロメッキ技術を適用している。加えて、微小ハンダボールを吐出するマイクロ溶融ハンダ吐出法によるバンプ形成技術を新たに開発した。この技術は、マスクを用いずにハンダバンプを形成でき、異なるサイズの微小バンプを混載させて形成することが可能である。 COC-FCBGAパッケージは、微小バンプを積層したベースチップを、従来のFC-BGAパッケージと同様の手法で多層基板へフリップチップ接続。そして、チップを積層したベースチップをFC-BGAパッケージと同様の手法で多層基板へフリップチップ接続する。これにより、従来と同一サイズでありながら機能・性能をさらに向上させたSiP製品が実現できる。 | ||||||||||||