湿式成膜法による半導体パッケージ技術
科学技術振興機構(JST)はこのほど、「湿式成膜法による半導体ウエハー上の再配線加工技術」の開発を成功と認定した。この開発は、関東学院大学工学部教授本間英夫氏らの研究成果を基に野毛電気工業(横浜市金沢区、佐藤中則社長)に委託して実用化を進めていたもの(図1参照)。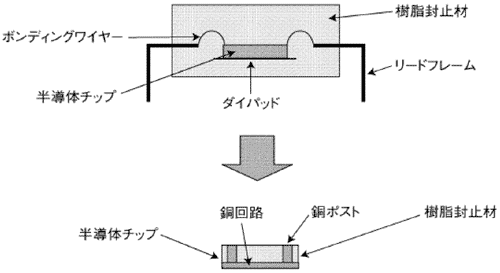 〔図1〕従来技術と新技術の比較 半導体の小型・軽量化に伴い、実装される基板を高精度に加工できる技術が必要となっている。最近、小型軽量化を目的としてW-CSP(Wafer Level Chip Size Package)と呼ぶパッケージ技術が導入され始めている。この技術は、ウエハー上で電極形成・再配線・樹脂封止を行い、最後にチップごとに切り分ける技術。この技術では、切断した半導体チップの大きさそのものがパッケージの大きさになるため小型・軽量化できること、ウエハー単位でパッケージングまですべての製造を行うためコストが低減できる特徴がある。 このW-CSPの電極形成・再配線は、乾式成膜法と湿式成膜法があり、主に乾式成膜法であるスパッタリング加工が用いられている。しかし、この方法は設備が高価であり大量生産には多大の設備投資を必要とする。湿式成膜法であるメッキは大量処理に向いているが、金属析出条件が難しくメッキ厚制御が難しかった。 この開発では、メッキにおける添加剤を適切に選定し、液中電位差の調整を行うことで析出条件を最適化。電極部へのニッケル・金メッキ処理をはじめ、加工精度の高い銅ポスト作製を可能として電極部からの加工技術を実現した。この技術での再配線加工技術は、成膜装置への投資額が軽減するだけでなく、メッキ槽の中で一度に多数のウエハー処理ができるので、電極形成、最配線加工が低コストで行うことが可能となる。 この技術による電極形成・再配線加工は以下のような工程で行われる(図2)。 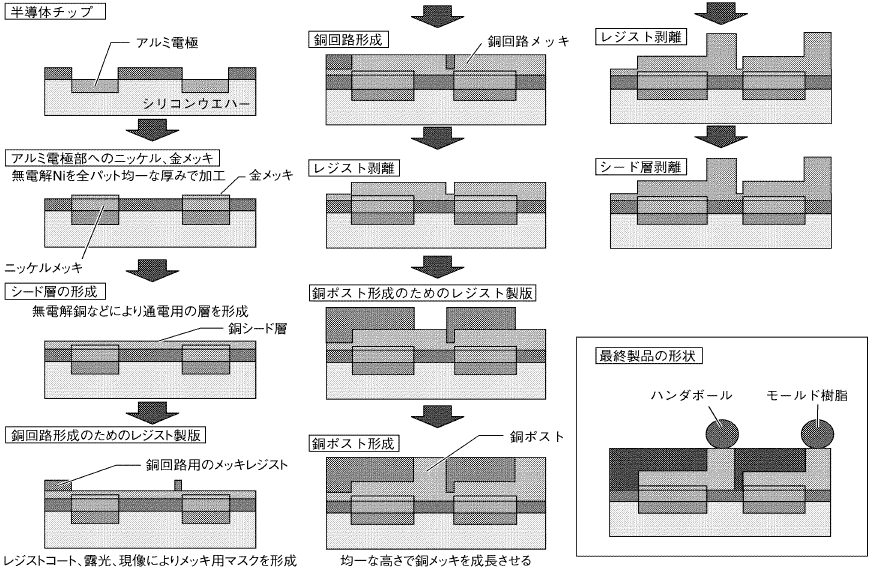 〔図2〕湿式成膜法による再配線加工工程式 (1) 回路を形成したシリコンウエハーに対して、無電解ニッケル・金メッキ処理を行い、電極上へのメッキ処理を行う。 (2) 再配線パターンを描くため、絶縁性のフォトレジストであるポリイミドをコーティング、露光処理し、2段階の銅メッキ(写真1)により、電極部から再配線層を形成する。  〔写真1〕電解銅メッキ装置 (3) フォトリソグラフィにより、パターンを形成し、銅メッキにより銅ポストを形成する(写真2)。 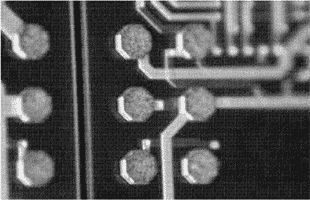 〔写真2〕銅ポストと再配線の拡大写真 なお、銅ポストは温度変化や衝撃により、基板とチップ内に発生する応力を緩和する。 この再配線加工技術は、小型半導体パッケージ製作分野、とくに携帯用電子機器などを中心にパソコン、携帯電話、デジタルカメラ、デジタルビデオ、DVDレコーダ、大型液晶TVなどのデジタル家電製品をはじめ、車載エレクトロニクス分野など、高密度半導体デバイスとしての利用が期待される。 <資料提供:独立行政法人科学技術振興機構>
|