丂僾儕儞僩攝慄斅
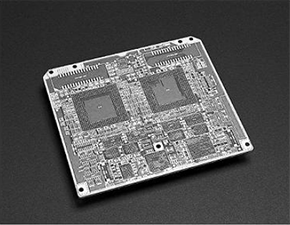
亂幨恀侾亃帺摦幵偱偼丄懴娐嫬惈偵桪傟偨
崅怣棅惈僾儕儞僩攝慄斅偑梫媮偝傟傞

亂幨恀俀亃俬俠撪憼婎斅媄弍偱係.俇亊俆.俇亊侾儈儕
僒僀僘偵彫宆壔偟偨僽儖乕僩僁乕僗儌僕儏乕儖
丂僾儕儞僩攝慄斅偼丄惉挿暘栰偵岦偗偨怴惢昳丄怴媄弍偺奐敪偑妶敪壔偟偰偄傞丅僗儅儂傗僞僽儗僢僩側偳偵偼丄價儖僪傾僢僾媄弍傪崅搙壔丅崅婡擻儌僕儏乕儖梡偼丄晹昳撪憼婎斅傗掅壏從寢僙儔儈僢僋乮俴俿俠俠乯婎斅偺媄弍傪嵦梡丅帺摦幵丄懢梲岝敪揹側偳偺惉挿暘栰岦偗傕崅懴擬丄戝揹棳懳墳偲偄偭偨怴媄弍傕傔偠傠墴偟丅偝傜偵丄僼儗僉僔僽儖攝慄斅乮俥俹俠乯偼丄攝慄帺桼搙傪堦抜偲崅傔偰偄傞丅
丂價儖僪傾僢僾懡憌斅偼僐傾憌偺椉柺偵攝慄偡傞憌傪愊傒廳偹傞岺朄偑堦斒揑偩偑丄嵟嬤偱偼慡憌儗乕僓乕價傾偍傛傃僼傿乕儖僪傔偭偒偵傛傞怣棅惈偺崅偄僄僯乕儗僀儎乕婎斅偑僗儅儂側偳偱嵦梡偝傟偰偄傞丅俴乮儔僀儞乯乛俽乮僗儁乕僗乯偼俆侽μ倣乛俆侽μ倣埲壓偺旝嵶壔媄弍傪揔梡丅儗乕僓乕價傾偺價傾宎偼俈俆μ倣埲壓偵彫宎壔丅偟偐傕婎斅岤傒偼丄俇憌偱侽.俁儈儕儊乕僩儖岤撪奜傪幚尰偟偰偄傞丅
丂崅婡擻儌僕儏乕儖偑丄僗儅儂側偳偺揹巕婡婍偵悢懡偔搵嵹偝傟傞傛偆偵側偭偨丅偦偙偱丄巊梡偝傟傞夞楬婎斅偲偟偰晹昳撪憼婎斅丄俴俿俠俠婎斅偺媄弍偑拲栚偝傟偰偄傞丅
丂晹昳撪憼婎斅偼丄婎斅撪偵庴摦晹昳傗俬俠傪撪憼偟丄偦偺忋晹慡柺偵攝慄憌偑愝偗傜傟丄條乆側僨僶僀僗傪俁師尦幚憰偡傞傕偺丅
丂晹昳撪憼婎斅偱偼丄敄宆壔傪捛媮偟偨俬俠偩偗傪婎斅偵撪憼偡傞俬俠撪憼婎斅傪偼偠傔丄崉惈偵桪傟僲僀僘傊偺懴惈偑岦忋偟丄偟偐傕崅偄擬揱摫棪傪帩偮偨傔丄俬俠僠僢僾側偳偐傜敪惗偡傞擬傪岠壥揑偵曻擬偱偒傞摵僐傾撪憼婎斅側偳丄庡梫奺幮偑撈帺偺媄弍傪嵦梡丅
丂俴俿俠俠婎斅媄弍傕崅搙壔丅儌僕儏乕儖梡偺堦斒揑側傾儖儈僫婎斅偵斾傋偰俉侽侽亷埲壓偺掅壏偱從寢偱偒傞偨傔丄掞峈丄僀儞僟僋僞丄僐儞僨儞僒側偳傪摨帪偵從寢偱偒傞丅
帺摦幵岦偗丄搵嵹揰悢憹偊傞
丂帺摦幵偼丄埨慡丄怣棅丄夣揔側偳傪媮傔偰揹巕壔偑恑揥偟丄僾儕儞僩攝慄斅偺搵嵹揰悢偑憹壛偟偰偄傞丅僷儚乕僩儗僀儞宯丄幵椉惂屼宯丄儃僨傿宯丄忣曬捠怣宯側偳丄嬶懱揑側傾僾儕働乕僔儑儞偛偲偵媄弍僯乕僘偑堎側傝丄偦傟偧傟偵嵟揔偵愝寁偝傟偨僾儕儞僩攝慄斅偑嫙媼偝傟傞丅帺摦幵偱嵟傕嫮偔梫媮偝傟傞偺偼崅怣棅惈丅幵嵹俤俠倀偼丄搵嵹娐嫬偑幒撪偐傜僄儞僕儞儖乕儉丄偝傜偵偼僄儞僕儞捈搵嵹傊偲曄壔偡傞偙偲偵傛偭偰丄懴擬惈偵桪傟偨僾儕儞僩攝慄斅偑梫媮偝傟傞丅偟偐傕彫宆壔偺梫媮偐傜丄僷僞乕儞僗儁僢僋偼偙傟傑偱偺俴乛俽亖侾俁侽μ倣乛侾俈侽μ倣偐傜丄摨侾侽侽μ倣乛侾侽侽μ倣丄偝傜偵偼摨俈俆μ倣乛俈俆μ倣傊偲旝嵶壔偑恑揥偡傞傕偺偲巚傢傟傞丅
丂傑偨丄俤倁丄俫俤倁偲偄偭偨僄僐僇乕偑晛媦偟丄偟偐傕儔儞僾椶偺俴俤俢壔傕恑揥丅偙傟傜偼丄曻擬婎斅傗戝揹棳婎斅傪嫮偔媮傔傞丅偦偺偨傔丄嬥懏儀乕僗婎斅丄嬥懏僐傾婎斅丄岤摵婎斅偺搵嵹傕恑揥偟偰偄傞丅
丂懢梲岝敪揹偼丄僜乕儔乕偵傛偭偰敪揹偝傟偨捈棳揹椡傪岎棳揹椡偵曄姺偡傞僷儚乕僐儞僨傿僔儑僫偑梡偄傜傟傞丅偦偺偨傔丄戝揹棳懳墳偺岤摵僾儕儞僩攝慄斅偑昁梫偵側傞丅
丂堦斒揑側僾儕儞僩攝慄斅偺夞楬岤傒偑俁俆μ倣撪奜偱偁傞偺偵懳偟偰丄侾侽侽乗俆侽侽μ倣偲偄偆摵岤偺夞楬傪宍惉偡傞偙偲偱戝揹棳傊偺懳墳傪壜擻偵偟偨傕偺偑岤摵婎斅丅俧俶俢丄倁俠俠偲偟偰偺戝揹棳夞楬偼傕偪傠傫丄俬俧俛俿傗僷儚乕俵俷俽俥俤俿丄僔儑僢僩僉乕僟僀僆乕僪側偳丄敪擬偡傞僷儚乕僨僶僀僗傪搵嵹偡傞夞楬偱巊梡偱偒傞丅
丂俥俹俠偼丄敄偔丄寉偔偰嬋偘偑壜擻偱偁傝丄攝慄帺桼搙偑崅偄偲偄偆摿挜偑梡搑傪奼戝偟偰偄傞丅敄宆壔偲偟偰椉柺俥俹俠偱偼丄敄偄俹俬僇僶乕僼傿儖儉偲曅柺俿俫傔偭偒媄弍偺慻崌傢偣偱丄曅柺攝慄晹偺岤傒俇俇μ倣丄曅柺攝慄晹乮働乕僽儖晹乯偺岤傒俁係μ倣傪幚尰偟偨丅挻敄宆働乕僽儖偲崅枾搙幚憰傪椉棫偟丄僗儅儂側偳偺掅攚壔丄寉検壔偵峷專偡傞丅敄宆懡憌俥俹俠偱偼丄係憌價儖僪峔憿偱丄憤岤侽.侾俋儈儕儊乕僩儖傪幚尰偟偨丅傑偨丄旝嵶壔媄弍偱偼丄儘乕儖to儘乕儖偵傛傞僙儈傾僨傿僥傿僽僾儘僙僗偱曅柺嵟彫僺僢僠俀俆μ倣傪幚尰偟偨挻旝嵶俥俹俠偑幚梡壔偝傟偰偄傞丅
丂帺摦幵偱偼丄揹巕壔恑揥偵敽偄丄儚僀儎僴乕僱僗偺悢検偑憹壛偟丄憤廳検偑廳偔側傞丅偦偺戙懼偲偟偰俥俹俠偺棙梡偑恑揥偟偰偄傞丅儔僀僩丄僙儞僒乕丄俙俿僊傾儃僢僋僗丄僒僀僪僞乕儞丄僗僀僢僠丄揹埑娔帇側偳丄搵嵹揰悢偑憹壛偟偰偄傞丅 丂